
芸卓新材拥有完整的临时键合解决方案,可全面支撑 2.5D、3D、FOWLP、FOPLP 等先进封装制程,专注服务于5G、AI、HPC、IoT 等领域,助力大算力、高带宽存储芯片的规模化量产。
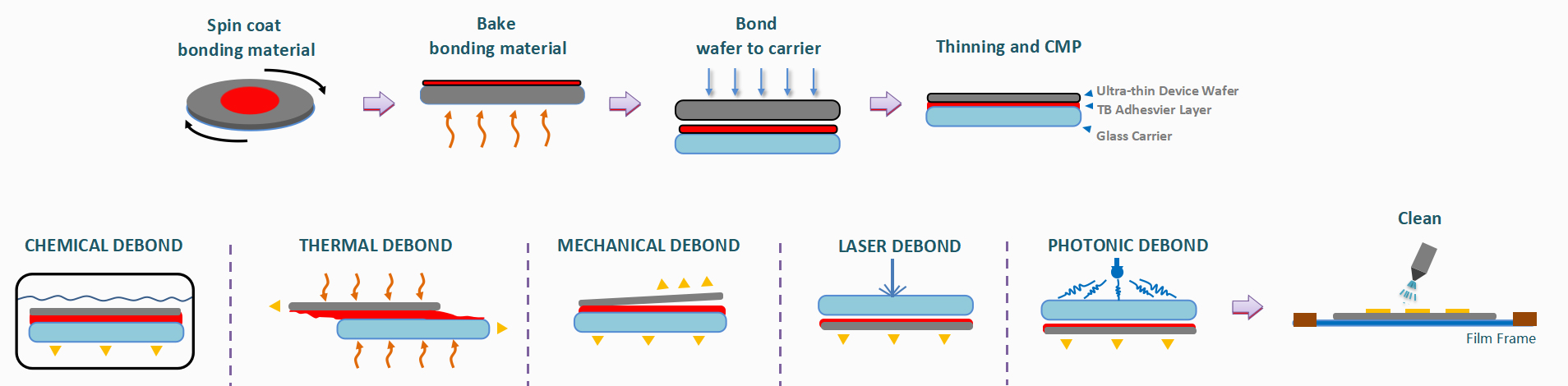
| 产品类别 | 产品 | 产品介绍 |
临时键合材料 (Adhesive Layer) | 2.5D CoWoS临时键合材料 | 针对 CoWoS 先进封装中的 TB1 与 TB2 工艺,提供优异支撑性、耐高温且易清洗的临时键合材料,可满足超薄晶圆加工及多芯片异构集成的临时键合需求。 |
| 3D HBM临时键合材料 | 针对 HBM 存储芯片的3D堆叠,提供机械解键合及激光解键合材料方案,产品具备优异的键合TTV 性能,可有效支撑晶圆 BVR 与 TCB 制程。 | |
| Hybrid Bonding临时键合材料 | 针对3D封装混合键合工艺,提供具备优异 TTV 特性与高温稳定性的临时键合材料,可支撑超薄晶圆在高温环境下完成 Cu-Cu 键合。 | |
| FOWLP/FOPLP临时键合材料 | 针对 Chip‑First HDFO 封装,提供高温高模量的临时键合材料,可满足晶圆级与板级的芯片贴装(Die Attach)需求。 | |
激光释放材料 (Release Layer) | 紫外激光释放材料 | 满足 308nm、355nm 激光解键合需求,提供兼具优异紫外吸收性能与耐化学腐蚀的激光释放材料,可适配各类先进封装制程。 |
| 绿光激光释放材料 | 适配532nm绿光解键合工艺,提供具有优异可见光吸收性能的激光释放材料。 | |
剥离液 (Stripper) | 临时键合剥离液 | 针对各类临时键合材料,芸卓新材提供配套剥离液,对UV膜、晶圆表面金属和PI绝缘介质等无腐蚀,且清洗效率高。 |
衬底材料 (Glass Carrier) | 玻璃晶圆 | 针对 HDFO、2.5D 等先进封装工艺,芸卓新材可提供多款不同 CTE 规格的玻璃材料,具备优异的尺寸加工精度与严格的颗粒、缺陷控制能力。 |